過去開發的半導體世代技術,很清楚地以製程技術和材料選擇來定義所謂的「贏家」。然而當尺寸微縮到小於14nm時,似乎有多種技術可以被選擇。舉例來說,對微影技術而言,可能可使用的技術包括進一步擴大 193i 的適用領域、採用極紫外線微影技術、定向自組裝技術( Directed Self Assembly, DSA),無遮罩微影技術(Mask Less Lithography, ML2)等等。至於電晶體的尺寸微縮,它可能是非平面元件結構和非矽材料(例如,III-V族)之組合。但它也可能意味著根據不同的應用,各家公司可能想要選擇非傳統的微縮方案,例如3D整合。
微影:對所有的選項持開放態度
浸沒式微影在193 nm仍然非常活躍 – 當工業界努力將極紫外線微影技術完備,以進入量產階段的時候,Nikon一直維持它在193的領先地位,並不斷改良193的能力以支援多種圖形和其他即將被使用的技術。「還不到宣布193i的死期」,根據美國Nikon Research Corporation資深研究科學家Stephen Renwick的評論,「當我們要進入10nm和7nm的時候(圖一、二),它仍然是一個非常活躍以及可行的選擇。」作為浸沒式微影技術的延伸,該公司的S622D型號已經開始出貨,並且正應用在14nm節點上,同時使用者希望能將它應用到10nm的邏輯節點上。Renwick 說,「S630D即將問世,並擬用到10nm並擴展到7nm的邏輯節點。」

圖一:微影技術的發展趨勢。資料來源:Nikon
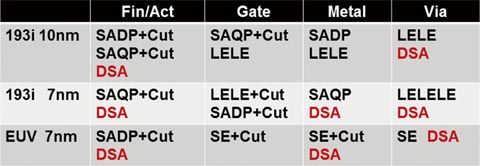
圖二:不同節點之選項。資料來源:Nikon
Nikon一直在評估一項次世代微影技術(next-generation lithography, NGL),就是所謂的定向自組裝(DSA)技術。它內含的掃描器可以製作出引導圖樣,指引塊狀共聚物(copolymer)進行自組裝的動作,預期可對193浸沒式掃描儀帶來額外的性能要求(例如,疊加overlay,CD均勻性)以製作出引導圖案。
Rathsack等人於論文中(Adv. Litho. 2012, Proc. SPIE, #8323)已經使用100nm的標記圖案做出12.5 nm的線條/間隔,這大約是7nm節點的要求。據Renwick所述,要滿足這些DSA在7nm的要求,193i掃描儀的疊加程度必須≤ 2nm,以及個位數的CDU – 這些要求該公司都能夠實現。
除了Nikon以外,還有其他組織努力擴大193i微影技術,讓它具有互補解決方案,例如DSA和無遮蓋微影功能(ML2)的是CEA – Leti組織,包括其IMAGINE(為ML2)和IDEAL(為DSA計畫。IMAGINE計劃的目的是開發和工業化高生產力的電子束無遮罩微影技術,該技術是由MAPPER Lithography所開發。成員包括:MAPPER、台積電、意法半導體、日產化學、TOK、JSR Micro、SOKUDO、TEL、Mentor Graphics、以及Aselta Nanographics。據CEA-Leti的微影技術經理Serge Tedesco所述,ML2在低量與中量生產上的製作成本得以減少。Tedesco跟SEMI說,「這種技術對處理越來越困難的臨界層(如接觸層)以及互補式微影的截斷層(cut level)來說應該頗具吸引力」。
就目前而言,IMAGINE計畫中預產原型機Matrix 1.1平台正穩步地建立。在Leti的安裝作業自2013年7月開始,預定首次曝光的時間是2014年6月。Matrix 1.1包含1300x49組電子束以達到1wph的生產目標。此原型機生產平台的規格與量產版(即32nm的L/S,10nm的疊加)是相同的。為了搭建該平台的基礎設施,Leti也將該平台與SOKUDO DUO Track聯結起來。與光阻供應商的工作正持續進行,同時電子束臨近效應修正(e-beam proximity correction, EPC)的數據庫正由Aselta建立 – Aselta是一家由Leti衍生的新創公司。此外Mentor Graphics和MAPPER宣布了一項合作夥伴關係計畫以支援Matrix的數據格式。
原型機的下一階段目標是使用13000組電子束來達成10wph的生產能力Matrix 10.1)。Matrix平台的發展路線圖將10.1的開始時程放在大約Q4/14直到Q1/15。在此之後是高量產的設備開發---Matrix 10.10---它將包含10個10wph/module的模組,總生產量將達到100wph(圖三)。

圖三:IMAGINE路線圖。資料來源:CEA-Leti
至於Leti 的DSA計畫,Tedesco報告說,其IDEAL方案在材料和製程整合方面都有所進展。Tedesco說,「最小線寬、CD 的控制和缺陷等參數都控制在能夠實施該技術的範圍內」。他補充說,合作夥伴如TOK,ASML,和Mentor Graphics將確保基礎設施建立完備。
另外有關 DSA 部分,另一個名為 PLACYD 的歐洲計劃已經在今年稍早的時候由 Arkema、Leti以及其他九個歐洲合作夥伴共同發起。該計畫將在Arkema(在法國Lacq)設立一條專用的材料試產線以提供DSA微影技術需要的模塊共聚物。計畫目標是提供被精確定義、具有高純度並且可以用工業規模大量生產的材料。關於ML2和DSA的未來,Tedesco抱持相當樂觀的態度,他說道「互補同時符合成本效益的解決方案,如DSA和 ML2,將可以延長193i 的應用到遠遠超出原先預期的時限。」
目前可能還不太清楚當電晶體微縮到接近5nm節點的時候需要解決的問題有那些。材料方面有許多一定要做出的選擇,也就是基板、通道和柵極材料。還有許多不同類型的元件結構 - 包括 FinFET、柵極全包式,甚至是非常規的選擇,例如隧道場效應管 (Tunnel FET) 和Nanowires – 由元件的應用區隔很難預料何者可以勝出。
原文請參閱《半導體科技雜誌 SST-AP Taiwan》

|
| Facebook |
|
按讚馬上加入北美智權報粉絲團 |
     |
|
|
|
|
|
|
|
|






